英飞凌适合高功率应用的QDPAK和DDPAK顶部冷却封装注册为JEDEC标准
【2023年4月13日,德国慕尼黑讯】追求高效率的高功率应用持续向更高功率密度及成本最佳化发展,也为电动汽车等产业创造了永续价值。为了应对相应的挑战,英飞凌科技股份公司(FSE代码:IFX / OTCQX代码: IFNNY)宣布其高压MOSFET器件适用的 QDPAK 和 DDPAK 顶部冷却 (TSC) 封装已成功注册为 JEDEC 标准。这项举措不仅进一步巩固了英飞凌将此标准封装设计和外型的TSC 封装推广至广泛新型设计的目标,也给OEM 厂商提供了更多的弹性与优势,帮助他们在市场中创造差异化的产品,并将功率密度提升至更高水准,以支持各种应用。
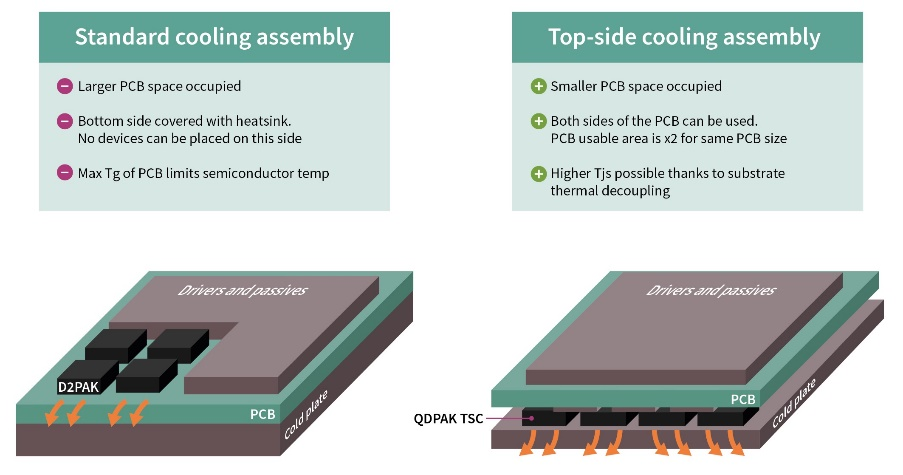
英飞凌科技高电压封装首席工程师Ralf Otremba表示:“作为解决方案提供商,英飞凌持续通过创新的封装技术和制程,对半导体产业发挥影响力。我们先进的顶部冷却封装为器件和系统层级带来显著的优势,能够满足尖端高功率设计的挑战性需求。封装外形的标准化可确保不同厂商设计的引脚兼容性——这是OEM厂商在高电压应用所面对的主要设计考量之一,由此可以让OEM厂商不再需要在这一方面耗费心力。”
半个多世纪以来,JEDEC组织持续领导全球微电子产业进行各项技术,包括封装外型的开放式标准的开发以及出版物编写工作。JEDEC广泛纳入了各种半导体封装,例如 TO220 和 TO247 通孔器件 (THD)——这类器件在过去几十年来受到广泛采用,目前仍是新型车载充电器 (OBC) 设计、高压 (HV) 和低压 (LV) DC-DC 转换器的设计选项。

QDPAK和DDPAK表面贴装(SMD)TSC封装设计的成功注册,标志着封装外形将迎来崭新纪元,将推动市场更广泛地采用 TSC 技术以取代 TO247 和 TO220。凭借这一技术优势以及根据MO-354 标准,此项新 JEDEC 注册封装系列将成为高压工业和汽车应用过渡至下一代平台中顶部冷却设计的重要推手。
为了协助客户进行TO220和TO247 THD器件的设计过渡,英飞凌特别推出可提供同等散热能力与较佳电气效能的 QDPAK 和 DDPAK SMD器件。适用于 HV 与 LV 器件的 QDPAK 和 DDPAK SMD TSC 封装采用 2.3 mm标准高度,可让开发人员使用所有相同高度的 SMD TSC 器件来设计完整应用,例如 OBC 和 DC-DC 转换。相较于必须使用 3D 冷却系统的现有解决方案,此封装不只对设计更有利,还可降低冷却系统成本。
另外,TSC封装最多可比标准底部冷却(BSC)降低35%的热阻。TSC 封装充分发挥 PCB 双面的效益,可提供较佳的电路板空间利用率以及至少两倍的功率密度。由于封装引脚热阻比外露的封装顶部高了许多,因此基板的热解耦也可提升封装的热管理。散热效能提升后,就不必再堆叠各种不同的板子。所有元件只要单一 FR4 就已足够,不用再结合 FR4 和 IMS,需要的接头也较少。这些功能对整体物料清单 (BOM) 都有助益,最终可降低整体系统成本。
除了提升散热和功率能力,TSC 技术也提供更佳的电源回路设计,因为驱动器配置可以非常靠近电源开关,所以更加稳定。驱动器开关回路的低杂散电感则可降低回路寄生效应,因此栅极振荡较少、效能较高、故障风险较小。
关于英飞凌
英飞凌科技股份公司是全球功率系统和物联网领域的半导体领导者。英飞凌以其产品和解决方案推动低碳化和数字化进程。该公司在全球拥有约56,200名员工,在2022财年(截至9月30日)的收入约为142亿欧元。英飞凌在法兰克福证券交易所上市(股票代码:IFX),在美国的OTCQX国际场外交易市场上市(股票代码:IFNNY)。
英飞凌中国
英飞凌科技股份公司于1995年正式进入中国大陆市场。自1995年10月在无锡建立第一家企业以来,英飞凌的业务取得非常迅速的增长,在中国拥有约3,000多名员工,已经成为英飞凌全球业务发展的重要推动力。英飞凌在中国建立了涵盖研发、生产、销售、市场、技术支持等在内的完整的产业链,并在销售、技术研发、人才培养等方面与国内领先的企业、高等院校开展了深入的合作。











暂无评论